Fotomáscara

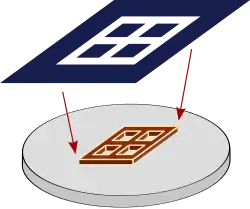
Uma fotomáscara (também chamada simplesmente de máscara) é uma placa opaca com áreas transparentes que permitem a passagem da luz em um padrão definido. As fotomáscaras são comumente usadas na fotolitografia para a produção de circuitos integrados (CIs ou "chips") para produzir um padrão em um fino wafer de material (geralmente silício). Na fabricação de semicondutores, uma máscara é às vezes chamada de rética.[1][2]
Na fotolitografia, várias máscaras são usadas sequencialmente, cada uma reproduzindo uma camada do projeto finalizado, e juntas conhecidas como um conjunto de máscaras. Uma fotomáscara curvilínea tem padrões com curvas, o que é uma divergência das fotomáscaras convencionais que possuem apenas padrões completamente verticais ou horizontais, conhecidos como geometria manhattan. Essas fotomáscaras requerem equipamentos especiais para fabricação.[3]
História
Para a produção de CIs na década de 1960 e início dos anos 1970, era usado um filme opaco de rubylith laminado sobre uma folha transparente de mylar. O projeto de uma camada era cortado no rubylith, inicialmente à mão em uma mesa de desenho iluminada (posteriormente por máquina (plotter)) e o rubylith indesejado era removido à mão, formando a imagem mestra daquela camada do chip, muitas vezes chamada de "arte final". Chips cada vez mais complexos e, portanto, maiores, exigiam rubyliths cada vez maiores, eventualmente preenchendo até a parede de uma sala, e as artes finais eram reduzidas fotograficamente para produzir fotomáscaras (Eventualmente, todo esse processo foi substituído pelo gerador de padrões ópticos para produzir a imagem mestra). Neste ponto, a imagem mestra podia ser organizada em uma imagem de múltiplos chips chamada rética. A rética era originalmente uma imagem 10 vezes maior de um único chip.
A rética era, por meio de fotolitografia e gravação de passo e repetição, usada para produzir uma fotomáscara com um tamanho de imagem igual ao do chip final. A fotomáscara podia ser usada diretamente na fábrica (fab) ou servir como uma fotomáscara mestra para produzir as fotomáscaras reais de trabalho finais.
À medida que o tamanho do elemento diminuiu, a única maneira de focar adequadamente a imagem era colocá-la em contato direto com o wafer. Esses alinhadores de contato frequentemente levantavam parte do fotorresiste do wafer para a fotomáscara, que precisava ser limpa ou descartada. Isso levou à adoção de fotomáscaras mestras reversas (ver acima), que eram usadas para produzir (com fotolitografia e gravação por contato) as muitas fotomáscaras reais de trabalho necessárias. Posteriormente, a fotolitografia por projeção significou que a vida útil da fotomáscara era indefinida. Ainda mais tarde, a fotolitografia stepper de passo direto no wafer (direct-step-on-wafer) usava réticas diretamente e pôs fim ao uso de fotomáscaras.
Os materiais das fotomáscaras mudaram com o tempo. Inicialmente, era usado vidro sodocalcárico[4] com opacidade de haleto de prata. Posteriormente, borossilicato[5] e depois sílica fundida para controlar a expansão, e crômio que tem melhor opacidade à luz ultravioleta foram introduzidos. Os geradores de padrões originais desde então foram substituídos por litografia por feixe de elétrons e sistemas de gravação de máscaras (mask writer) acionados por laser ou sistemas de litografia sem máscara que geram réticas diretamente a partir do projeto computadorizado original.
Visão geral

As fotomáscaras litográficas são tipicamente placas transparentes de sílica fundida cobertas com um padrão definido com um filme absorvente metálico de crômio (Cr) ou Fe2O3.[6] As fotomáscaras são usadas em comprimentos de onda de 365 nm, 248 nm e 193 nm. Fotomáscaras também foram desenvolvidas para outras formas de radiação, como 157 nm, 13,5 nm (EUV), raios X, elétrons e íons; mas estes requerem materiais totalmente novos para o substrato e o filme do padrão.[6]
Um conjunto de fotomáscaras, cada um definindo uma camada de padrão na fabricação de circuitos integrados, é alimentado em um stepper ou scanner de fotolitografia, e individualmente selecionado para exposição. Em técnicas de multipadronagem, uma fotomáscara corresponderia a um subconjunto do padrão da camada.
Historicamente, na fotolitografia para a produção em massa de dispositivos de circuito integrado, havia uma distinção entre o termo fotorrética ou simplesmente rética, e o termo fotomáscara. No caso de uma fotomáscara, há uma correspondência um-para-um entre o padrão da máscara e o padrão do wafer. A máscara cobria toda a superfície do wafer, que era exposta em sua totalidade em uma única tomada. Este era o padrão para os alinhadores de máscara 1:1 que foram sucedidos por steppers e scanners com óptica de redução.[7] Conforme usado em steppers e scanners que usam projeção de imagem,[8] a rética normalmente contém apenas uma cópia, também chamada de uma camada do projeto de circuito VLSI. (No entanto, algumas fábricas de fotolitografia utilizam réticas com mais de uma camada colocada lado a lado na mesma máscara, usadas como cópias para criar vários circuitos integrados idênticos a partir de uma fotomáscara). No uso moderno, os termos rética e fotomáscara são sinônimos.[9]
Em um stepper ou scanner moderno, o padrão na fotomáscara é projetado e reduzido por quatro ou cinco vezes na superfície do wafer.[10] Para alcançar a cobertura completa do wafer, o wafer é repetidamente "stepped" (avançado) de posição em posição sob a coluna óptica ou a lente do stepper até que a exposição total do wafer seja alcançada. Uma fotomáscara com várias cópias do projeto do circuito integrado é usada para reduzir o número de avanços necessários para expor todo o wafer, aumentando assim a produtividade.
Elementos de 150 nm ou abaixo geralmente requerem deslocamento de fase para melhorar a qualidade da imagem para valores aceitáveis. Isso pode ser alcançado de várias maneiras. Os dois métodos mais comuns são usar um filme de fundo de deslocamento de fase atenuado na máscara para aumentar o contraste dos pequenos picos de intensidade, ou gravar a sílica exposta para que a borda entre as áreas gravadas e não gravadas possa ser usada para imagear intensidade quase zero. No segundo caso, bordas indesejadas precisariam ser removidas com outra exposição. O primeiro método é o deslocamento de fase atenuado, e é frequentemente considerado um realce fraco, exigindo iluminação especial para o máximo realce, enquanto o segundo método é conhecido como deslocamento de fase de abertura alternada, e é a técnica de realce forte mais popular.
À medida que os elementos semicondutores de ponta encolhem, os elementos da fotomáscara que são 4 vezes maiores devem inevitavelmente encolher também. Isso pode representar desafios, pois o filme absorvedor precisará se tornar mais fino e, portanto, menos opaco.[11] Um estudo de 2005 do IMEC descobriu que absorvedores mais finos degradam o contraste da imagem e, portanto, contribuem para a rugosidade da borda da linha, usando ferramentas de fotolitografia state-of-the-art.[12] Uma possibilidade é eliminar os absorvedores completamente e usar máscaras "sem crômio" (chromeless), confiando apenas no deslocamento de fase para imageamento.[13][14]
O surgimento da litografia por imersão tem um forte impacto nos requisitos da fotomáscara. A máscara de deslocamento de fase atenuada comumente usada é mais sensível aos ângulos de incidência mais altos aplicados na litografia "hiper-NA", devido ao caminho óptico mais longo através do filme padronizado.[15] Durante a fabricação, a inspeção usando uma forma especial de microscopia chamada CD-SEM (Microscopia Eletrônica de Varredura de Dimensão Crítica) é usada para medir dimensões críticas em fotomáscaras, que são as dimensões dos padrões em uma fotomáscara.[16]
Litografia EUV
As fotomáscaras EUV funcionam refletindo a luz,[17] o que é alcançado usando múltiplas camadas alternadas de molibdênio e silício.
Fator de aumento de erro de máscara (MEEF)
Fotomáscaras de ponta (pré-corrigidas) são imagens dos padrões finais do chip ampliadas por quatro vezes. Este fator de ampliação tem sido um benefício chave na redução da sensibilidade do padrão a erros de imageamento. No entanto, à medida que os elementos continuam a encolher, duas tendências entram em jogo: a primeira é que o fator de erro da máscara começa a exceder um, ou seja, o erro dimensional no wafer pode ser mais de 1/4 do erro dimensional na máscara,[18] e a segunda é que o elemento da máscara está se tornando menor, e a tolerância dimensional está se aproximando de alguns nanômetros. Por exemplo, um padrão de wafer de 25 nm deve corresponder a um padrão de máscara de 100 nm, mas a tolerância do wafer poderia ser de 1,25 nm (especificação de 5%), o que se traduz em 5 nm na fotomáscara. A variação da dispersão do feixe de elétrons na gravação direta do padrão da fotomáscara pode facilmente exceder isso.[19][20]
Películas
O termo "película" (pellicle) é usado para significar "filme", "filme fino" ou "membrana". A partir da década de 1960, filmes finos esticados em um quadro metálico, também conhecidos como "película", foram usados como divisores de feixe para instrumentos ópticos. Tem sido usado em vários instrumentos para dividir um feixe de luz sem causar uma mudança no caminho óptico devido à sua pequena espessura de filme. Em 1978, Shea et al. na IBM patentearam um processo para usar a "película" como uma capa de proteção contra poeira para proteger uma fotomáscara ou rética. No contexto desta entrada, "película" significa "capa de proteção contra poeira de filme fino para proteger uma fotomáscara".
A contaminação por partículas pode ser um problema significativo na fabricação de semicondutores. Uma fotomáscara é protegida de partículas por uma película – um filme transparente fino esticado sobre uma armação que é colada sobre um lado da fotomáscara. A película está longe o suficiente dos padrões da máscara para que partículas de tamanho moderado a pequeno que pousem na película fiquem muito fora de foco para imprimir. Embora sejam projetadas para manter as partículas afastadas, as películas tornam-se parte do sistema de imageamento e suas propriedades ópticas precisam ser levadas em consideração. Os materiais das películas são nitrocelulose e feitos para vários comprimentos de onda de transmissão. As películas atuais são feitas de polissilício, e as empresas estão explorando outros materiais para EUV de alta NA, como CNT (nanotubos de carbono),[21][22][23] e futuros processos de fabricação de chips.[24][25]

Principais fabricantes comerciais de fotomáscaras
A Conferência Anual da SPIE, Photomask Technology relata a Avaliação da Indústria de Máscaras do SEMATECH que inclui análise atual da indústria e os resultados de sua pesquisa anual com fabricantes de fotomáscaras. As seguintes empresas estão listadas em ordem de sua participação de mercado global (informações de 2009):[26]
- Dai Nippon Printing
- Toppan Photomasks (agora Tekscend)
- Photronics Inc
- Hoya Corporation
- Taiwan Mask Corporation
- Compugraphics
Grandes fabricantes de chips, como Intel, GlobalFoundries, IBM, NEC, TSMC, UMC, Samsung e Micron Technology, possuem suas próprias grandes instalações de fabricação de máscaras ou joint ventures com as empresas mencionadas acima.
O mercado mundial de fotomáscaras foi estimado em US$ 3,2 bilhões em 2012[27] e US$ 3,1 bilhões em 2013. Quase metade do mercado era de mask shops cativos (mask shops internas de grandes fabricantes de chips).[28]
Os custos de criação de uma nova mask shop para processos de 180 nm foram estimados em 2005 em US$ 40 milhões, e para 130 nm - mais de US$ 100 milhões.[29]
O preço de compra de uma fotomáscara, em 2006, poderia variar de US$ 250 a US$ 100 000[30] para uma única máscara de deslocamento de fase de alta qualidade. Podem ser necessárias até 30 máscaras (de preço variável) para formar um conjunto de máscaras completo. Como os chips modernos são construídos em várias camadas empilhadas umas sobre as outras, pelo menos uma máscara é necessária para cada uma dessas camadas.
Referências
- ↑ «Fabricação de Réticas». KLA (em inglês). Consultado em 5 de janeiro de 2024
- ↑ Diaz, S.L.M.; Fowler, J.W.; Pfund, M.E.; Mackulak, G.T.; Hickie, M. (Novembro de 2005). «Avaliando os Impactos dos Requisitos de Réticas na Fabricação de Wafers de Semicondutores». IEEE Transactions on Semiconductor Manufacturing (em inglês). 18 (4). pp. 622–632. ISSN 0894-6507. doi:10.1109/TSM.2005.858502
- ↑ «A Busca por Fotomáscaras Curvilíneas». 15 de abril de 2021
- ↑ Introduction to Microfabrication. [S.l.]: John Wiley & Sons. 29 de outubro de 2010. ISBN 978-1-119-99189-2
- ↑ Handbook of Photomask Manufacturing Technology. [S.l.]: CRC Press. 3 de outubro de 2018. ISBN 978-1-4200-2878-2
- ↑ a b Shubham, Kumar n (2021). Integrated circuit fabrication. Ankaj Gupta. Abingdon, Oxon: [s.n.] ISBN 978-1-000-39644-7. OCLC 1246513110
- ↑ Rizvi, Syed (2005). «1.3 The Technology History of Masks». Handbook of Photomask Manufacturing Technology. [S.l.]: CRC Press. 728 páginas. ISBN 9781420028782
- ↑ Principles of Lithography. [S.l.]: SPIE Press. 2005. ISBN 978-0-8194-5660-1
- ↑ «Réticas»
- ↑ Especialistas em litografia apoiam maior ampliação em fotomáscaras para facilitar desafios // EETimes 2000
- ↑ Y. Sato et al., Proc. SPIE, vol. 4889, pp. 50-58 (2002).
- ↑ M. Yoshizawa et al., Proc. SPIE, vol. 5853, pp. 243-251 (2005)
- ↑ Toh, Kenny K.; Dao, Giang T.; Singh, Rajeev R.; Gaw, Henry T. (1991). «Máscaras de deslocamento de fase sem crômio: uma nova abordagem para máscaras de deslocamento de fase». In: Wiley, James N. 10th Annual Symp on Microlithography. 1496. [S.l.: s.n.] pp. 27–53. doi:10.1117/12.29750
- ↑ Eom, Tae-Seung; Lim, Chang M.; Kim, Seo-Min; Kim, Hee-Bom; Oh, Se-Young; Ma, Won-Kwang; Moon, Seung-Chan; Shin, Ki S. (2003). «Estudo comparativo de máscara de deslocamento de fase sem crômio e atenuada para litografia ArF de 0,3-k 1 de DRAM». In: Yen, Anthony. Optical Microlithography XVI. 5040. [S.l.: s.n.] pp. 1310–1320. doi:10.1117/12.485452
- ↑ C. A. Mack et al., Proc. SPIE, vol. 5992, pp. 306-316 (2005)
- ↑ «CD-SEM: Microscópio Eletrônico de Varredura de Dimensão Crítica»
- ↑ «Visão Geral da Metrologia de Máscaras EUV» (PDF). Consultado em 23 de junho de 2019. Arquivado do original (PDF) em 2 de junho de 2017
- ↑ E. Hendrickx et al., Proc. SPIE 7140, 714007 (2008).
- ↑ C-J. Chen et al., Proc. SPIE 5256, 673 (2003).
- ↑ W-H. Cheng and J. Farnsworth, Proc. SPIE 6607, 660724 (2007).
- ↑ «Materiais avançados de nanotubos de carbono para películas EUV». Canatu (em inglês). 8 de maio de 2023. Consultado em 2 de junho de 2025
- ↑ Ueda, Takahiro; Lima, Marcio D.; Harada, Tetsuo; Kondo, Takeshi (1 de junho de 2023). «Películas baseadas em CNT para a próxima geração de scanners EUV». Japanese Journal of Applied Physics. 62 (SG). pp. SG0805. ISSN 0021-4922. doi:10.35848/1347-4065/acbbd5
- ↑ «www.spiedigitallibrary.org/conference-proceedings-of-spie/13216/1321615/Improved-CNT-based-pellicles-for-low-and-high-power-EUV/10.1117/12.3034650.short». doi:10.1117/12.3034650.short (inativo 18 de julho de 2025)
- ↑ «O que é EUV de Alta NA? - Breakfast Bytes - Cadence Blogs - Cadence Community». community.cadence.com. Consultado em 26 de março de 2025
- ↑ Chris A. Mack (Novembro de 2007). «Comportamento óptico das películas». Microlithography World. Consultado em 13 de setembro de 2008
- ↑ Hughes, Greg; Henry Yun (1 de outubro de 2009). «Avaliação da indústria de máscaras: 2009». In: Zurbrick, Larry S.; Montgomery, M. Warren. Photomask Technology 2009. Proceedings of SPIE. 7488. [S.l.: s.n.] pp. 748803–748803–13. Bibcode:2009SPIE.7488E..03H. ISSN 0277-786X. doi:10.1117/12.832722
- ↑ Chamness, Lara (7 de maio de 2013). «Mercado de Fotomáscaras para Semicondutores: Previsão de US$ 3,5 bilhões em 2014». SEMI Industry Research and Statistics. Consultado em 6 de setembro de 2014
- ↑ Tracy, Dan; Deborah Geiger (14 de abril de 2014). «A SEMI relata vendas de fotomáscaras para semicondutores de 2013 de US$ 3,1 bilhões». SEMI. Consultado em 6 de setembro de 2014
- ↑ Weber, Charles M.; Berglund, C. Neil (9 de fevereiro de 2005). Uma Análise da Economia da Fabricação de Fotomáscaras Parte – 1: O Ambiente Econômico (PDF). ISMT Mask Automation Workshop. p. 6. Arquivado do original (PDF) em 3 de março de 2016.
Indústria intensiva em capital. Níveis de investimento….. – ~US$ 40M para 'convencionais' (nó de 180 nm ou acima) – >US$ 100M para 'avançados' (nó de 130 nm e além)
- ↑ Weber, C.M; Berglund, C.N.; Gabella, P. (13 de novembro de 2006). «Custo e Rentabilidade da Máscara na Fabricação de Fotomáscaras: Uma Análise Empírica» (PDF). IEEE Transactions on Semiconductor Manufacturing. 19 (4). pp. 465–474. doi:10.1109/TSM.2006.883577 doi:10.1109/TSM.2006.883577; página 23 tabela 1