Litografia ultravioleta extrema
A litografia ultravioleta extrema (Extreme ultraviolet lithography ou EUVL em inglês), também conhecida simplesmente como EUV) é uma tecnologia usada na indústria de semicondutores para a fabricação de circuitos integrados (CIs). É um tipo de fotolitografia que usa luz ultravioleta extrema (EUV) de 13,5 nm proveniente de um plasma de estanho (Sn) pulsado por laser para criar padrões complexos em substratos semicondutores.
Desde 2025, ASML Holding é a única empresa que produz e vende sistemas EUV para produção de chips, visando nós de processo de 5 nanômetros (nm) e 3 nm, embora a Reuters tenha relatado em dezembro de 2025 que a China desenvolveu seu próprio protótipo de sistema EUV.[1]
Os comprimentos de onda EUV usados em EUVL estão próximos de 13,5 nanômetros (nm), usando um plasma de gotículas de estanho (Sn) pulsado por laser para produzir um padrão usando uma fotomáscara reflexiva para expor um substrato coberto por fotorresistente. Íons de estanho nos estados iônicos do Sn IX para Sn XIV apresentam picos espectrais de emissão de fótons em torno de 13,5. nm de transições de estado iônico 4p 6 4d n – 4p 5 4d n +1 + 4d n −1 4f.[2]
Projeção de crescimento do mercado
De acordo com um relatório da Pragma Market Research,[3] o mercado global de litografia ultravioleta extrema (EUV) deverá crescer de US$ 8.957,8 milhões em 2024 para US$ 17.350 milhões até 2030, a uma taxa de crescimento anual composta de 11,7%. Esse crescimento significativo reflete a crescente demanda por eletrônicos miniaturizados em diversos setores, incluindo smartphones, inteligência artificial e computação de alto desempenho.
Ferramenta
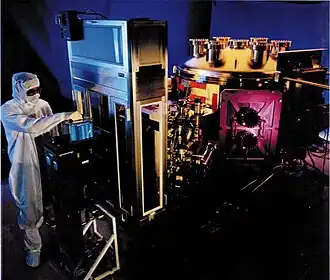
Uma ferramenta EUV (máquina de fotolitografia EUV) possui uma fonte de luz de plasma de estanho (Sn) acionada por laser, ótica reflexiva composta por espelhos multicamadas, contida em um ambiente de gás hidrogênio.[4] O hidrogênio é usado para manter o espelho coletor EUV, já que este é o primeiro espelho a coletar a radiação EUV emitida em uma ampla faixa de ângulos (~2π).sr) do plasma de Sn, na fonte livre de deposição de Sn.[5] Especificamente, o gás tampão de hidrogênio na câmara ou recipiente da fonte EUV desacelera ou possivelmente empurra de volta os íons de Sn e os detritos de Sn que viajam em direção ao coletor EUV (proteção do coletor) e permite uma reação química de remover a deposição de Sn no coletor na forma de gás (restauração da refletividade do coletor).
Referências
- ↑ Potkin, Fanny (17 de dezembro de 2025). «Exclusive: How China built its 'Manhattan Project' to rival the West in AI chips». Reuters. Consultado em 17 de dezembro de 2025
- ↑ O'Sullivan, Gerry; Li, Bowen; D'Arcy, Rebekah; Dunne, Padraig; Hayden, Paddy; Kilbane, Deirdre; McCormack, Tom; Ohashi, Hayato; O'Reilly, Fergal (2015). «Spectroscopy of highly charged ions and its relevance to EUV and soft x-ray source development». Journal of Physics B: Atomic, Molecular and Optical Physics. 48 (14). Bibcode:2015JPhB...48n4025O. doi:10.1088/0953-4075/48/14/144025 Verifique o valor de
|url-access=subscription(ajuda) - ↑ O'Sullivan, Gerry; Li, Bowen; D'Arcy, Rebekah; Dunne, Padraig; Hayden, Paddy; Kilbane, Deirdre; McCormack, Tom; Ohashi, Hayato; O'Reilly, Fergal (2015). «Spectroscopy of highly charged ions and its relevance to EUV and soft x-ray source development». Journal of Physics B: Atomic, Molecular and Optical Physics. 48 (14). Bibcode:2015JPhB...48n4025O. doi:10.1088/0953-4075/48/14/144025 Verifique o valor de
|url-access=subscription(ajuda) - ↑ O'Sullivan, Gerry; Li, Bowen; D'Arcy, Rebekah; Dunne, Padraig; Hayden, Paddy; Kilbane, Deirdre; McCormack, Tom; Ohashi, Hayato; O'Reilly, Fergal (2015). «Spectroscopy of highly charged ions and its relevance to EUV and soft x-ray source development». Journal of Physics B: Atomic, Molecular and Optical Physics. 48 (14). Bibcode:2015JPhB...48n4025O. doi:10.1088/0953-4075/48/14/144025 Verifique o valor de
|url-access=subscription(ajuda) - ↑ O'Sullivan, Gerry; Li, Bowen; D'Arcy, Rebekah; Dunne, Padraig; Hayden, Paddy; Kilbane, Deirdre; McCormack, Tom; Ohashi, Hayato; O'Reilly, Fergal (2015). «Spectroscopy of highly charged ions and its relevance to EUV and soft x-ray source development». Journal of Physics B: Atomic, Molecular and Optical Physics. 48 (14). Bibcode:2015JPhB...48n4025O. doi:10.1088/0953-4075/48/14/144025 Verifique o valor de
|url-access=subscription(ajuda)